
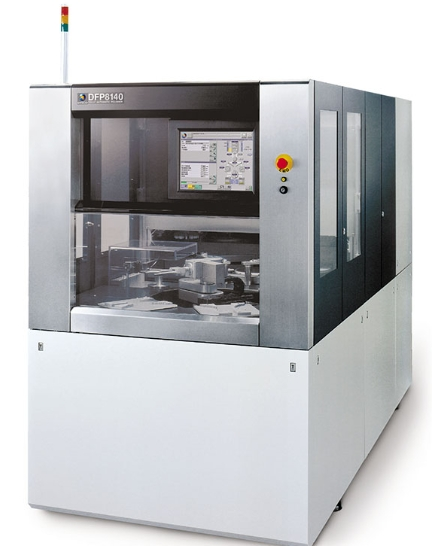
1、日本DISCO公司晶圆抛光机DFP8140
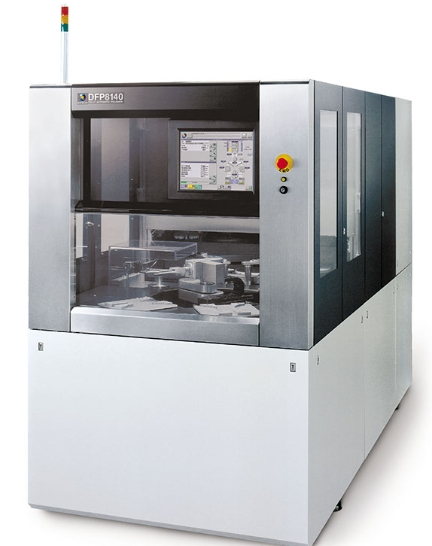
实现不使用化学制剂应力释放的Φ8英寸干式抛光机
Φ200 mm
1 axis, 1 chuck table
Wafer Thinning
Stress Releaf
提高薄型晶圆的良品率
DFP8140是完全不使用研磨液(Slurry)就可以去除晶圆背面损伤层(应力释放, Stress Relief ),可对应Φ8英寸晶圆的干式抛光的设备。即能够防止圆晶碎裂及翘曲,增加芯片的抗弯强度,提高良品率,又能够减少环境负荷。
可与现有的研削机联机(In-Line)运行
DFP8140可与现有的研削机整合联机(可现场改装),利用与DFG8540的联机功能(特殊选配),可以安全地进行晶圆搬送。
降低环境负荷
因为是干式抛光加工,所以没有处理湿式刻蚀或CMP加工时所需的化学药品的程序。既降低了环境负荷,又有助于减少用户的运行成本。
操作简便
配置了触摸式液晶显示器及GUI (Graphical User Interface),提高了操作便利性。控制画面可同步显示加工状况和设备状态,操作人员只要触摸控制画面上的按钮,就可以简单地完成操作。更便利于日常设备操作和维修保养时的操作。
Specifications
Specification Unit DFP8140
Supported workpiece size - Φ4/5/6/8 inch(Select one size)
Polishing Method - Anomalous In-feed grinding with wafer rotation
Wheel - Φ300 mm Dry Polishing Wheel
Chuck table type - Porous chuck table
Chuck-method - Vacuum
Number of revolutions min‐1 0 ~ 300
Chuck table cleaning - Water & air thrust up, Leveling stone and brush cleaning
Spindle Rated output kW 4.8
Rotation speed range min‐1 1,000 ~ 4,000
Internal load sensor - Thin force sensor
Spinner unit - Wafer washing and drying by atomizing nozzle
Equipment dimensions (W×D×H) mm 1,200 × 2,670 × 1,800
Equipment weight kg Approx.1,900
2、日本DISCO公司晶圆抛光机DFP8141

特别针对于蓝宝石和SiC等硬脆材料加工的CMP抛光机
Φ200 mm
1 axis, 2 chuck tables
Wafer Thinning
Stress Releaf
全自动加工机型
以Cassette to Cassette的方式来实现CMP加工的全自动机型。并且配备有清洗站,能够自动完成加工后晶圆的清洗与干燥。
适用于小尺寸的难切削材料
适用于蓝宝石,SiC,LT,LN等材料的CMP加工。
对应三种圆晶形态的搬运系统
可实现晶圆单独搬运,衬底基板搬运,框架搬运。

Specifications
Specification Unit
Supported workpiece size - Φ8 inch
Polishing method - CMP
Polishing wheel - Φ300 mm CMP pad
Spindle Rated output kW 7.5
Rotation speed range min‐1 500 ~ 2,000
Equipment dimensions (W x D x H) mm 900 x 2,584 x 2,000
Equipment weight kg Approx.3,100
3、日本DISCO公司晶圆抛光机DFP8160
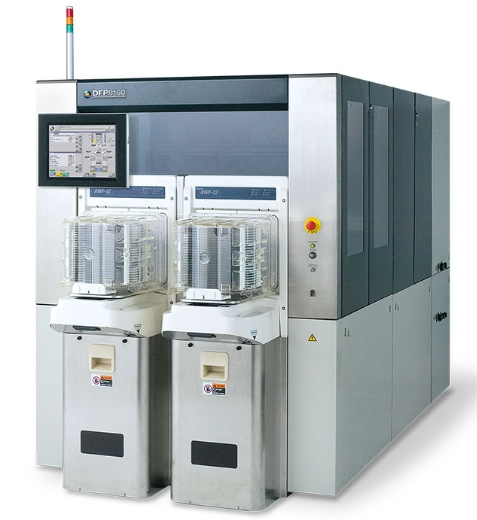
咨询电话:13522079385
实现不使用化学制剂应力释放的Φ300 mm干式抛光机
Φ300 mm
1 axis, 1 chuck table
Wafer Thinning
Stress Releaf
提高薄型晶圆的良品率
DFP8160是完全不使用研磨液(Slurry)就可以去除晶圆背面损伤层(应力释放, Stress Relief ) ,可对应Φ300 mm晶圆的干式抛光的设备。即能够防止圆晶碎裂及翘曲,增加芯片的抗弯强度,提高良品率,又能够减少环境负荷。
可与现有的研削机联机(In-Line)运行
DFP8160可与现有的研削机整合联机(可现场改装), 利用与DFG8560的联机功能(特殊选配),可以安全地进行设备之间的晶圆搬送。
降低环境负荷
因为是干式抛光加工,所以没有处理湿式刻蚀或CMP加工时所需的化学药品的程序。因此既降低了环境负荷,又有助于减少用户的运行成本。
操作简便
配置了触摸式液晶显示器及GUI (Graphical User Interface),提高了操作便利性。控制画面可同步显示加工状况和设备状态,操作人员只要触摸控制画面上的按钮,就可以简单地完成操作。更便利于日常设备操作和维修保养时的操作。
Specifications
Specification Unit DFP8160
Supported workpiece size - Φ200, 300 mm (Select one size)
Polishing Method - Anomalous In-feed grinding with wafer rotation
Wheel - Φ450 mm Dry Polishing Wheel
Chuck table type - Porous chuck table
Chuck-method - Vacuum
Number of revolutions min‐1 0 ~ 300
Chuck table cleaning - Water & air thrust up, Leveling stone and brush cleaning
Spindle Rated output kW 7.5
Rotation speed range min‐1 1,000 ~ 3,000
Internal load sensor - Thin force sensor
Spinner unit - Wafer washing and drying by atomizing nozzle
Equipment dimensions (W×D×H) mm 1,400 × 3,322 × 1,800
Equipment weight kg Approx.2,400
4、日本DISCO公司晶圆抛光机DGP8761
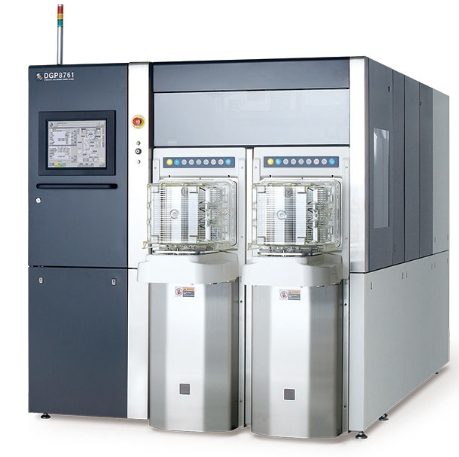
追求高效率的Φ300 mm研削拋光机
Φ300 mm
3 axes, 4 chuck tables
DBG
SDBG
Wafer Thinning
Stress Releaf
提高加工稳定性,实现更高的生产效率
DGP8761是全球销售业绩突出的DGP8760的改良机型。通过背面研削到去除应力的一体化,可以稳定地实施厚度在25 μm以下的薄型化加工。搭载了新开发的主轴,适用于高速研削加工,有助于缩短薄型晶圆的加工时间(于DGP8760相比较)。另外,优化了搬运部机构的布局,缩短了加工以外的作业時間。
第三主轴的多样化应用
作为薄晶圆加工的第3主轴可以有以下选择。
应力释放(Stress Relief)
有利于环保,不使用药液/水的「干式拋光加工」
CMP(特殊选项)
超精密研削加工(特殊选项)
Poligrind
UltraPoligrind
利用第三主轴实现外质吸杂※的应用
※外质吸杂:是在Si晶圆内由研削而形成微细的变质层(吸杂区域), 在该吸杂区域内可以捕获/固定重金属等杂质的技术
Gettering DP
采用干式抛光,兼顾高抗弯强度和维持外质吸杂效果的迪思科独有的解决方案。
研磨轮「UltraPoligrind」
采用微细磨粒「UltraPoligrind」,无需使用化学药物即可进行薄型晶圆加工。既可维持由于研削产生的外质吸杂效果,又可够获得以往研磨轮所无法得到的高抗弯强度。
系统扩展功能
与多功能晶圆贴膜机「DFM2800」联机使用,可一次性完成薄型晶圆DAF薄膜(Die Attach Film)贴膜作业。并且可对应DBG(Dicing Before Grinding)工艺(特殊选项)。
维持与现有8000系列机型间的兼容性及零部件互换性
DGP8761的研磨轮、磨轮修整板等与现有8000系列机型具有互换性。另外,该机型的操作方法及GUI(Graphical User Interface)的画面构成方面也与现有机型具有大量共通性。
加工物流程系统
用机械手臂将晶圆从晶圆盒中取出,放到中心定位台上进行中心定位、
用T1取物手臂将晶圆搬运到工作台上→
进行粗研磨加工→
进行细研磨加工→
进行干式抛光加工(去除残余应力)→
用T2取物手臂将晶圆从工作台移到离心清洗台上→
进行清洗→干燥→
移到贴膜机上(DFM2800)。 或者由机械手臂将工作物送回到晶圆盒。
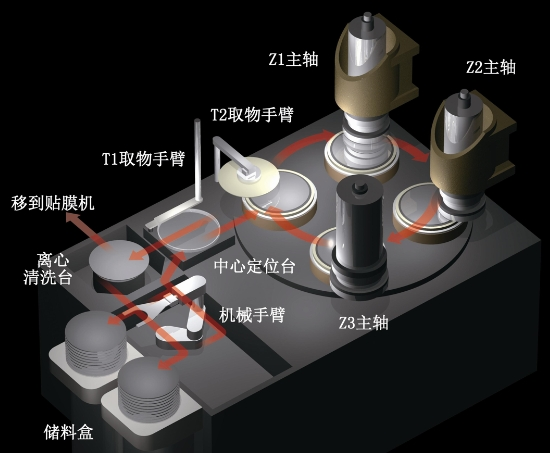
Specifications
Specification Unit
Supported workpiece size mm Φ300(Φ200 / Φ300)
Grinding Method (Z1/Z2 axis) - In-feed grinding with wafer rotation
Grinding Method (Z3 axis) - Anomalous in-feed grinding with wafer rotation
Grinding Wheels - Φ300 mm Diamond wheel (grinding-axis)
Φ450 mm Dry polishing pad (DP-axis)
Φ450 mm CMP pad (CMP-axis)
Equipment dimensions (W×D×H) mm 1,690 × 3,315 × 1,800 (open cassette)
1,690 × 3,452 × 1,800 (FOUP)
Equipment weight kg Approx. 6,700(DP, Poligrind)
Approx. 6,900 (CMP)
※为了改善,机器的外观,特征,规格等本公司可能在未预先通知用户的情况下实施变更。
※使用时,请先确认标准规格书。