
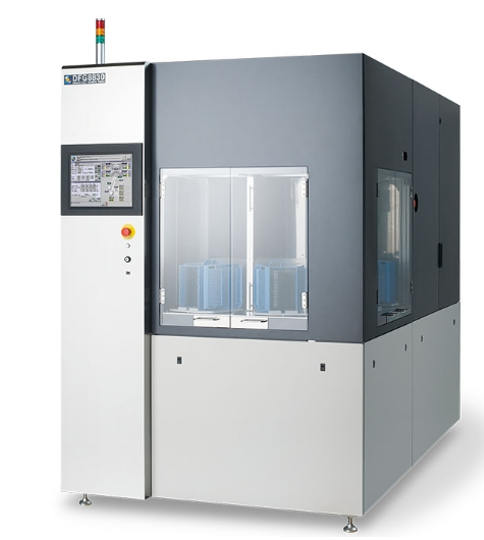
1、日本DISCO公司晶圆减薄机DFG8340

适用于高精度研削量较少的研削加工
Φ200 mm
1 axis, 2 chuck tables
稳定的高精度晶圆研削加工
随着电子元器件高集成化的发展,追求高平坦度的晶圆制造工程中也开始采用表面研削(Grinding)技术。DFG8340是在世界各地备受好评的DFG830后继机种,通过搭载高刚度主轴,可最小程度地降低加工时所产生的热影响,实现稳定的高平坦化晶圆加工。
适用于Φ8英寸以下的各种晶圆
采用单主轴,双工作台/一个旋转台的结构,实现了简单且紧凑的全自动研削机。可广泛适用于φ8英寸以下低损伤研磨量较少的硅晶圆,SiC,蓝宝石,陶瓷等其他材料的研削加工。
从Lapping到Grinding的置换
通常的Lapping是通过游离磨粒对晶圆进行批量加工,所以难以控制最终加工厚度。 DFG8340可即时测定晶圆厚度,并且只使用纯水进行加工, 能够在降低环境负荷的同时提高加工品质。
操作简便
配置了触摸式液晶显示器及GUI (Graphical User Interface),提高了操作便利性。控制画面可同步显示加工状况和设备状态,操作人员只要触摸控制画面上的按钮,就可以简单地完成操作。更便利于日常设备操作和维修保养时的操作。
简便的晶圆形状调整
只需在操作画面上触碰图形化按钮,就可以调整晶圆形状,实现了稳定的高精度加工。
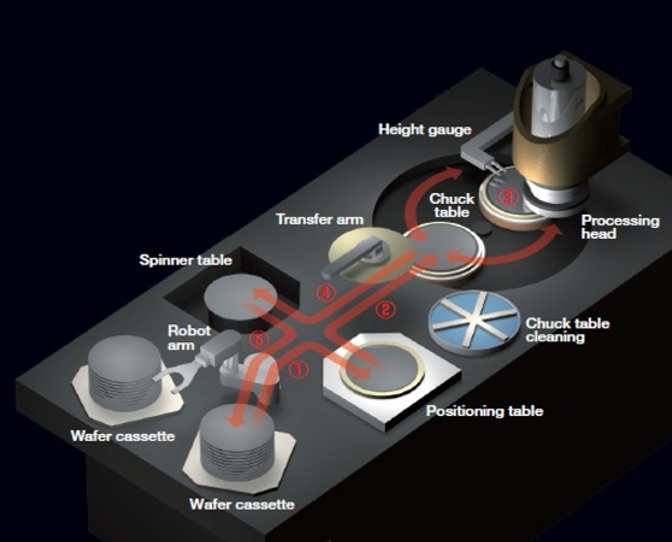
工作流程系统
机器手臂从料盒里取出工件、以定位工作盘确认中心
以搬运手臂放入加工工作盘上
研磨
搬运手臂把工件从加工工作盘移送到清洗工作盘
清洗→干燥
机器手臂把工件放入料盒中
Specifications
Specification Unit
Supported workpiece size - Φ4, 5, 6, 8 inch
Grinding Method - Anomalous In-feed grinding with wafer rotation
Grinding Wheels - Φ200 mm Diamond Wheel
Spindle Rated output kW 4.2
Rotation speed range min‐1 1,000 ~ 7,000
Equipment dimensions (W × D × H) mm 800 × 2,450 × 1,800
Equipment weight kg Approx.2,500
2、日本DISCO公司晶圆减薄机DFG8541

强化加工品质和可用性,适用于各种材料的全自动研削机
Φ200 mm
2 axes, 3 chuck tables
Wafer Thinning
可对应Φ8英寸、是标准机的升级机型
DFG8541是应对Φ8英寸以下晶圆减薄的需求, 研发的双主轴全自动研削机。该机型为标准研削机DFG8540的升级机型, 不仅可对应Si(硅片), 而且还可对应SiC(碳化硅)等高硬度难研削材料的薄片研削。
可对各种材料进行高品质的加工
通过高功率主轴(选项功能),提高了对各种材料进行研削加工的对应能力,并且通过改良影响晶圆厚度波动的晶圆形状调整,晶圆搬送,清洗等各种结构,实现了高品质的加工。
为实现高品质加工的各种结构
通过电动微调轴,可在界面上进行高精度的晶圆形状调整,通过摄像进行非接触式圆心调整功能以减少对晶圆的接触,通过采用二流体实现高清洗性能,等各种结构。

提高可用性
通过搭载新型GUI・控制系统, 可实现更直观的界面操作。而且追加了诸如, 可在同一个晶圆盒内选择单片晶圆的条件, 表面保护膜粘贴状态的异常探测, 晶圆斜装以及空片的探测等, 提高可用性功能
节省空间,节省能源
通过优化布局和内藏式真空装置, 于传统机型相比占地面积减少了15%,并且, 通过采用新型空气主轴, 空气消耗量减少了50%
加工流程图
由机械手臂将晶圆从晶圆盒中取出
放到定位台上进行中心定位
用T1取物手臂将晶圆搬运到工作盘上
Z1/Z2主轴进行研削加工
用T2取物手臂将晶圆从工作盘移到离心清洗台上
对晶圆进行清洗,干燥
由机械手臂将晶圆送回到晶圆盒
Specifications
Specification Unit
Supported workpiece size - Φ8 inch
When using universal chuck table: Φ4, 5, 6, 8 inches
Grinding method - In-feed grinding with workpiece rotation
Grinding wheel - Φ200 mm diamond wheel
Spindle Rated output kW 4.2
Rotation speed range min‐1 1,000 - 7,000
Equipment dimensions (W x D x H) mm 1,100 × 2,800 × 1,800
Equipment weight kg Approx.3,000
3、日本DISCO公司晶圆减薄机DFG8640

追求多样化加工材料的高精度研削
Φ200 mm
2 axes, 3 chuck tables
DBG
高精度研削
由于部分功率元器件和传感器件在研削后所产生的厚度偏差(晶圆间的偏差,单片晶圆内的偏差)会影响其产品特性,需要高精度的研削。 DFG8640通过优化加工点的布局以及搭载各种机构,实现了高精度的研削。
适用于最大Φ8英寸的各种材料
采用2个主轴,3个工作台/1个旋转台构造的全自动研削机。适用于Φ8英寸以下的Si(硅),LiTaO3(LT/钽酸锂),LiNbO3 (LN/铌酸锂),以及SiC(碳化硅)等难研削材料,可对应各种晶圆的研削。
搭载了高精度研削用的机构
为了实现高精度/高品质的加工,搭载了高刚性・低振动且回转速度变动小的主轴。工作台的主轴亦同样搭载高刚性・低振动・低热膨胀且回转速度变动小的空气轴承部件。
提高操作性能
搭载了新型的GUI (Graphical User Interface),可使用同等于智能型手机或平板电脑的触控・滑动等直观性操作。而且可不受页面阶层限制,快速从任意页面进入目的页面。
提高单位面积生产力
与以往机型DFG8540相比约减少了13%的占地面积。此外,通过清洗机构动作时间的缩短以及搬运手臂动作的调整,与DFG8540相比每小时的搬运片数提高了1.2倍以上。
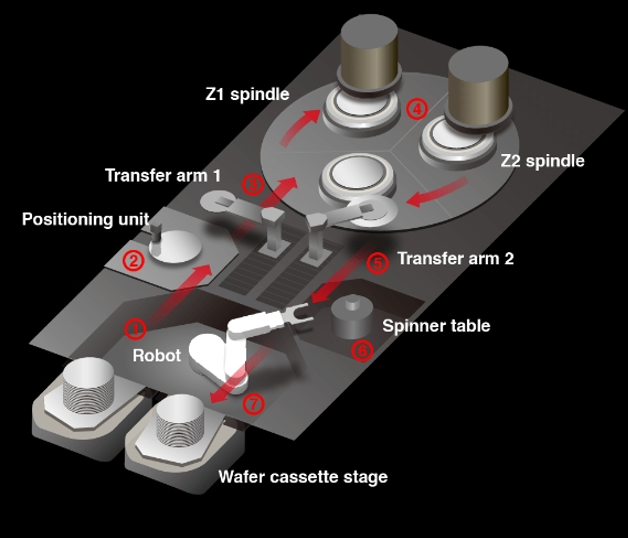
咨询电话:13522079385
工作流程系统
机器手臂从料盒里取出工件
以定位工作盘确认中心
以搬运手臂1放入加工工作盘
以Z1,Z2主轴研磨
以搬运手臂2把工件放入清洗工作盘
清洗→干燥→
机器手臂把工件放入料盒中
Specifications
Specification Unit
Supported workpiece size - Φ8 inch
Grinding method - In-feed grinding with wafer rotation
Grinding wheel - Φ200 mm Diamond Wheel
Spindle Rated output kW 6
Rotation speed range min‐1 1,000 ~ 7,000
Equipment dimensions (W x D x H) mm 1,000 x 2,800 x 1,800
Equipment weight kg Approx.3,500
4、日本DISCO公司晶圆减薄机DFG8830
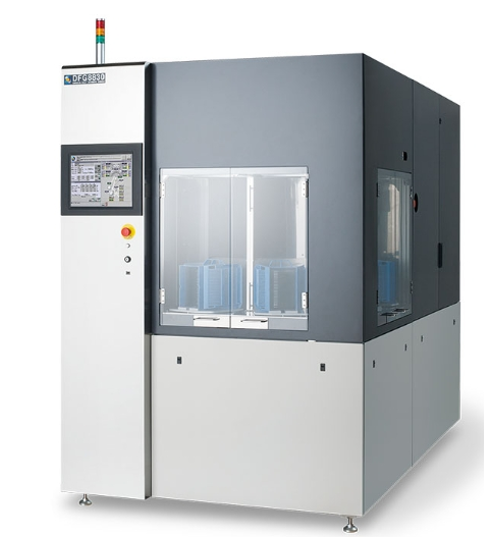
适合硬脆材料薄型化研削的研削机
Φ150 mm
4 axes, 5 chuck tables
对应硬脆材料的研削加工
适合蓝宝石和SiC等硬脆材料研削加工的研削机。通过搭载高刚性高输出功率的主轴以及大口径研削磨轮,可实现对加工负荷较高的硬脆材料的全自动研削。
4主轴5工作台的结构
采用4个加工主轴结构,一个旋转盘/5个工作台,可实现各种研削应用。通过选择最适合的4个主轴磨轮,可对应诸如重视生产效率或以减少圆晶损伤为目标的高品质加工等各种不同的加工需求。
附带支撑基板圆晶的加工
可对应固定在玻璃或陶瓷等衬底基板(基板)上的圆晶加工。 可对应Φ5∼8英寸的支撑基板,总厚度最大为3.5 mm的加工物。
节省占地面积
通过优化加工轴和搬运部的布局,追求紧凑的尺寸规格。虽然采用了4轴5工作台的结构,但是设置面积仅为3.5 m2 ,节省了占地面积。
操作简便
配置了触摸式液晶显示器及GUI (Graphical User Interface),控制画面可同步显示加工状况和设备状态,操作人员只要触摸控制画面上的按钮,就可以简单地完成操作。此外, 可同时搭载4个晶圆盒, 减少了操作人员更换晶圆盒的频率,减轻了设备操作的负担。
加工物流程系统
机械手臂从晶圆盒中取出加工物,并在定位盘上进行定位后,
利用搬送手臂搬送至工作台
Z1轴研削
Z2轴研削
Z3轴研削
Z4轴研削
搬送手臂將圆晶从工作台搬送至清洗台→
清洗→干燥→
机械手臂將圆晶放置到晶圆盒中
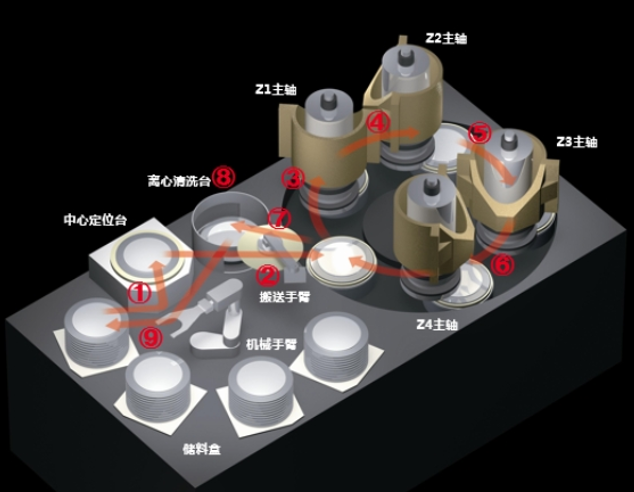
Specifications
Specification Unit
Supported workpiece size - Φ4, 5, 6 inch
Substrate Diameter - Φ5, 6, 8 inch
Grinding method - In-feed grinding with wafer rotation
Grinding wheel - Φ300 mm Diamond Wheel
Spindle Rated output kW 6.3
Rotation speed range min‐1 1,000 ~ 4,000
Equipment dimensions (W x D x H) mm 1,400 × 2,500 × 2,000
Equipment weight kg Approx.6,000
5、日本DISCO公司晶圆减薄机DAG810

对应最新加工需求的半自动研削机
Φ200 mm
1 axis, 1 chuck table
简单紧凑的单轴研削机
单主轴,单工作台,结构简单紧凑的研削机。最大可对应Φ8英寸的加工物
节省空间的设计
设备尺寸为600(W)×1,700(D)×1,780(H) mm。实现了占地面积仅为1.02 m2的小型化设计。
实现更高精度研削结果的机械结构及研削方式
通过采用高刚性,低振动的主轴,实现了更好的研削加工品质。研削方式可对应轴向进给 (In-Feed)研削和深切缓进给 (Creep-Feed)研削(作为特殊选配)。
也可广泛适用于硅晶圆以外的材料
可有效于硬质和脆性材料以及电子元件产品的研削加工
操作简便
配置了触摸式液晶显示器及GUI (Graphical User Interface),提高了操作便利性。控制画面可同步显示加工状况和设备状态,操作人员只要触摸控制画面上的按钮,就可以简单地完成操作。
可对应各种需求
探针式高度计(Height Gauge)
可对应单探针/双探针(选配)
轴向进给(In-Feed)研削
最大可加工Φ300 mm(选配)
带框架研削
可对应Φ8英寸框架(选配)
深切缓进给(Greep-Feed)研削
最大可加工Φ200 mm(选配)
高精度加工应用实例
可用于硅晶圆,半导体化合物等的研削
可用于CSP/WL-CSP的树脂研削及铜电极露出加工
提高LT/LN等的平坦度
可用于生陶瓷、蓝宝石等研削加工
Specifications
Specification Unit
Supported workpiece size - Φ8 inch
(Φ4, 5, 6, 8 inch with universal chuck table use)
Grinding Method - Anomalous In-feed grinding with wafer rotation
Grinding Wheels - Φ200 mm Diamond Wheel
Spindle Rated output kW 4.2
Rated torque N・m 5.9
Rotation speed range min‐1 1,000 ~ 7,000
Equipment dimensions (W × D × H) mm 600 × 1,700 × 1,780
Equipment weight kg Approx.1,300