
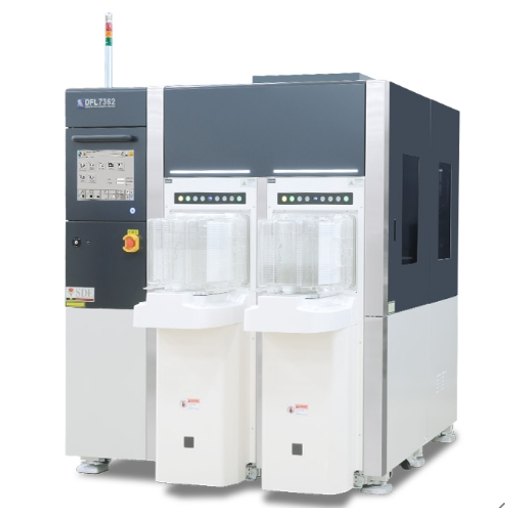
1、日本DISCO晶圆激光切割机DFL7160
支持各种应用,包括全切割和 DAF 切割
Φ300毫米
消融

DFL7160是一款用于Φ300mm晶圆的全自动激光切割机,采用脉冲激光实现非热加工。
该模型已广泛应用于许多应用中,例如 GaAs 全切割和 DBG 后的 DAF 切割。
通过安装 HogoMax *涂层/清洁机制可以防止激光加工颗粒对晶圆造成污染。
*水溶性保护膜,可防止激光加工颗粒粘附在晶圆表面
采用短脉冲激光
减少因加热引起的加工变形和变形,实现高品质加工。
与各种应用程序的兼容性
DFL7160 还支持去除低 k 凹槽或街道上的 TEG 以及对硅和化合物半导体进行全切割的应用。
割缝检查功能
自动检查和调整激光切割位置。该功能作为标准规格安装,可以实现稳定的处理。
规格
单元 | DFL7160 | ||
加工方法 | - | 消融 | |
最大限度。工件尺寸 | 毫米 | Φ300 | |
X轴(卡盘工作台) | 加工范围 | 毫米 | 310 |
移动速度 | 毫米/秒 | 0.1~600 | |
Y轴(卡盘工作台) | 加工范围 | 毫米 | 310 |
索引步长 | 毫米 | 0.0001 | |
定位精度 | 毫米 | 0.003/310 | |
Z轴 | 移动分辨率 | 毫米 | 0.00005 |
重复精度 | 毫米 | 0.002 | |
θ轴(卡盘工作台) | 最大限度。旋转角度 | 度 | 380 |
设备尺寸(宽×深×高) | 毫米 | 1,200 × 1,550 × 1,800 | |
设备重量 | 千克 | 大约1,750 | |
*产品外观、功能、规格和其他细节可能会因技术修改而发生变化。
*使用前请仔细阅读标准规格表。
2、日本DISCO晶圆激光切割机DFL7161
全自动激光锯

高质量、高产量的标准激光开槽模型
Φ300毫米
消融
DFL7161是一款用于Φ300毫米晶圆的全自动激光切割机,已得到广泛应用。
它执行从HogoMax *涂层、切割到自动清洁的一系列过程。
HogoMax 涂层和清洁部分分开设置,可显着减少等待时间。
*水溶性保护膜,可防止激光加工颗粒粘附在晶圆表面
*电梯盖为用户指定规格。
与各种应用程序的兼容性
DFL7161 还支持去除低 k 凹槽或街道上的 TEG 以及对硅和化合物半导体进行全切割的应用。
高速轴
通过改进传输和加工轴性能提高最大速度,从而实现更高的生产率。
割缝检查功能
自动检查和调整激光切割位置。该功能作为标准规格安装,可以实现稳定的处理。
规格
规格 | 单元 | DFL7161 | |
加工方法 | - | 消融 | |
最大限度。工件尺寸 | 毫米 | Φ300 | |
X轴(卡盘工作台) | 加工范围 | 毫米 | 310 |
移动速度 | 毫米/秒 | 1 ~ 1,000 | |
Y轴(卡盘工作台) | 加工范围 | 毫米 | 310 |
索引步长 | 毫米 | 0.0001 | |
定位精度 | 毫米 | 0.003/310 (单个错误)0.002/5 | |
Z轴 | 移动分辨率 | 毫米 | 0.000015 |
重复精度 | 毫米 | 0.002 | |
θ轴(卡盘工作台) | 最大限度。旋转角度 | 度 | 330(标准) 380(可选) |
设备尺寸(宽×深×高) | 毫米 | 1,560 × 1,550 × 1,800 | |
设备重量 | 千克 | 大约 2,300 | |
3、日本DISCO晶圆激光切割机DFL7341
全自动激光锯

实现蓝宝石、钽酸锂和 MEMS 加工的高生产率
Φ200毫米
隐形切割™
SDBG
SDTT
DFL7341是一款全自动Φ8英寸晶圆激光切割机,广泛应用于LED蓝宝石基板、硅麦克风等领域。
Stealth Dicing™ 工艺使得 SiC 和 GaN 等脆性材料能够在不碎裂的情况下进行分割。
这是一个完全干式的工艺,使其适合加工 MEMS 等易受水损坏的器件。
高度调节功能:Stealth Dicing™工艺可以根据晶圆表面高度进行,从而可以可靠地处理具有严重翘曲的晶圆。
晶圆形状识别:使用高分辨率传感器测量晶圆形状,以在最佳处理区域进行分割。
与各种材料的兼容性:使用适合每种材料的激光振荡器,可以对蓝宝石、SiC 和 GaAs 实现高质量加工。
DISCO 是 Hamamatsu Photonics 的联盟合作伙伴*,该公司拥有 Stealth Dicing 技术的专利组合。
*系统集成商是拥有 Hamamatsu Stealth Dicing 技术专利组合全面许可的业务合作伙伴。
规格
规格 | 单元 | DFL7341 | |
加工方法 | - | 隐形切割™ | |
最大限度。工件尺寸 | 毫米 | Φ200 | |
X轴(卡盘工作台) | 加工范围 | 毫米 | 210 |
移动速度 | 毫米/秒 | 1 ~ 1,000 | |
Y轴(卡盘工作台) | 加工范围 | 毫米 | 210 |
索引步长 | 毫米 | 0.0001 | |
定位精度 | 毫米 | 0.003/210 (单个错误)0.002/5 | |
Z轴 | 移动分辨率 | 毫米 | 0.0001 |
重复精度 | 毫米 | 0.001 | |
θ轴(卡盘工作台) | 最大限度。旋转角度 | 度 | 380 |
设备尺寸(宽×深×高) | 毫米 | 950 × 1,732 × 1,800 | |
设备重量 | 千克 | 大约 1,800 | |
4、日本DISCO晶圆激光切割机DFL7362
全自动激光锯
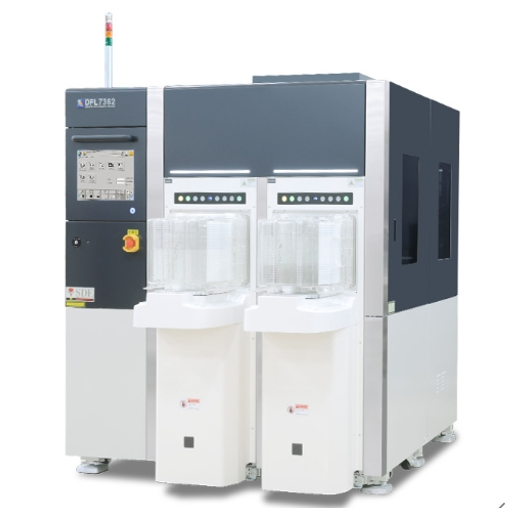
兼容多种工艺的激光锯,实现超薄硅的高速、高质量加工
Φ300毫米
隐形切割™
SDBG
SDTT
DFL7362是一款全自动Φ300mm晶圆激光切割机,主要用于超薄硅片的切割。
厚度为 50 µm 或更小的 Si 可以在保持高芯片强度的同时进行高速单片化。
该设备提供晶圆和框架传输,使其能够支持广泛的应用。
高通量
UPH 提高了约。除了减少晶圆传输和对准时间之外,还通过提高最大 X 轴速度和加速度实现 30% 的性能提升。
多种选择
DFL7362 与与质量和生产率相关的各种选项兼容,例如晶圆厚度测量和不间断切口检查。

咨询电话:15910974236
DISCO 是 Hamamatsu Photonics 的联盟合作伙伴*,该公司拥有 Stealth Dicing 技术的专利组合。
*系统集成商是拥有 Hamamatsu Stealth Dicing 技术专利组合全面许可的业务合作伙伴。
规格
规格 | 单元 | DFL7362 | |
加工方法 | - | 隐形切割™ | |
最大限度。工件尺寸 | 毫米 | Φ300 | |
X轴(卡盘工作台) | 加工范围 | 毫米 | 310 |
移动速度 | 毫米/秒 | 0.1~2,000 | |
Y轴(卡盘工作台) | 加工范围 | 毫米 | 310 |
索引步长 | 毫米 | 0.0001 | |
定位精度 | 毫米 | 0.003/310 (单个错误)0.002/5 | |
Z轴 | 移动分辨率 | 毫米 | 0.000005 |
重复精度 | 毫米 | 0.001 | |
θ轴(卡盘工作台) | 最大限度。旋转角度 | 度 | 380 |
设备尺寸(宽×深×高) | 毫米 | 1,600 × 2,755 × 1,800 | |
设备重量 | 千克 | 大约2,850 | |
5、日本DISCO晶圆激光切割机DFL7560L

使用 DPSS 激光器的具有宽工艺余量的激光剥离设备
Φ150毫米
激光剥离
激光剥离是通过对基板上形成的材料层照射激光,将材料层从基板上分离的技术。DFL7560L是一款用于Φ6英寸晶圆的全自动激光剥离机,可实现高加工速度使用 DPSS(固态)激光器实现高加工质量。
由于使用 DISCO 独特开发的光学器件可以在较宽的焦点范围内以最佳功率进行处理,因此减少了晶圆损坏和分离。而且,蓝宝石分离后的表面粗糙度极低。
与使用气体激光器的一般分离设备相比,维护时间大幅减少,加工质量更加稳定。

高吞吐量
由于螺旋加工发生在一定方向上,因此可以在高速下进行高效分离,而无需加工轴过多的加速和减速时间。

稳定的加工质量
激光照射区域内的能量峰值波动较小,对于包括Micro LED在内的许多极小芯片可以实现高成品率的稳定加工。
工艺流程
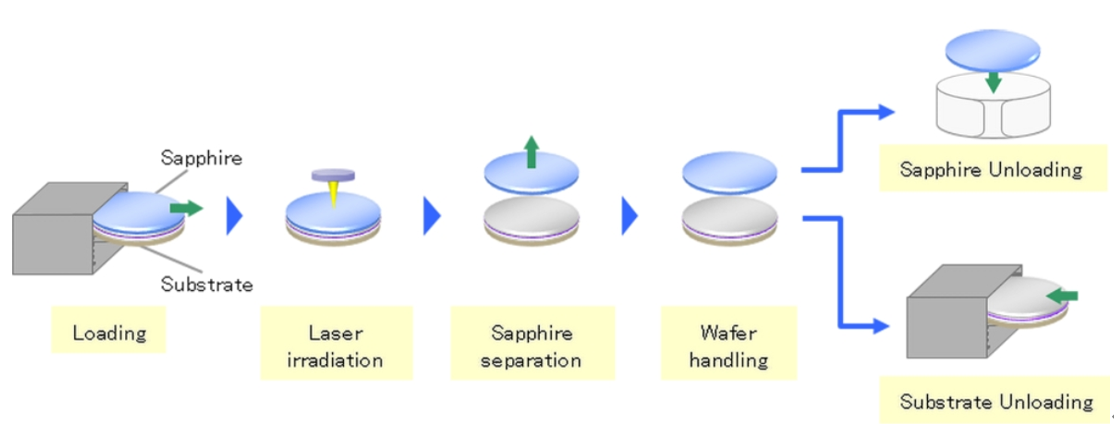
规格
规格 | 单元 | DFL7560L | |
加工方法 | - | 激光剥离 | |
最大限度。工件尺寸 | 毫米 | Φ300 | |
X轴(卡盘工作台) | 加工范围 | 毫米 | Φ310 |
移动速度 | 毫米/秒 | 1~600 | |
Y轴(卡盘工作台) | 加工范围 | 毫米 | Φ310 |
索引步长 | 毫米 | 0.0001 | |
Z轴 | 重复精度 | 毫米 | 0.002 |
设备尺寸(宽×深×高) | 毫米 | 2,000 × 1,810 × 1,800 | |
设备重量 | 千克 | 大约3,300 | |