德国scia Systems离子束修剪设备
2025-06-09 10:30:45
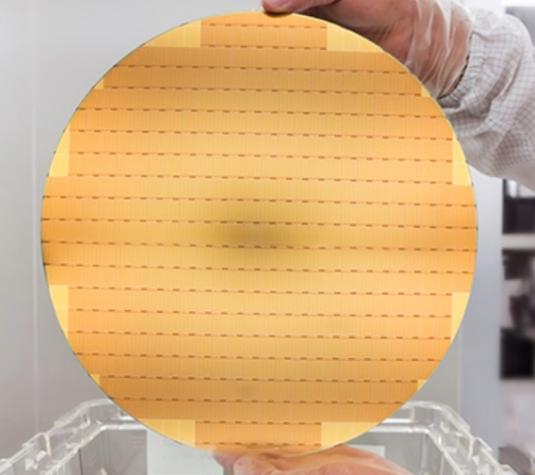
离子束修剪和离子束计算:下一代应用的精确表面修改
离子束修剪和离子束处理是光学、微电子和纳米技术等领域用于精密表面修改和校正的先进高真空技术。
与传统的机械抛光方法不同的是,IBT工艺和IBT工艺都不需要物理接触。正电荷离子的聚焦宽束,例如,氦,穿过衬底表面。离子与衬底原子的碰撞启动了\"碰撞级联\",导致单个粒子从表面分离。去除量受处理时间的控制。离子束在一个位置停留的时间越长,去除的材料就越多。由于这两种形式都是物理过程,可以加工各种材料。
离子束贴图是光基板抛光误差修正的一种特殊形式。它也常被称为:离子束抛光,或 离子束整理 ,因为它通常是一系列处理步骤中的最后一步。
离子束修剪和离子束的优点:
高精度 :加工具有极高的表面精度和单纳米图形校正。
非接触进程 :因此,离子束修剪不会给周围地区带来机械应力或损害,从而提高设备的可靠性。
高选择性 通过添加活性气体(活性离子束修剪),使之成为复杂器件结构的理想选择。
离子束修剪和离子束涂装设备
1、Scia Trim200
大批量生产系统,用于对不超过200毫米的晶圆进行薄膜厚度校正
离子束修剪
离子束图
精确的表面校正:
… 200号饰带 用于高精度的晶圆表面修剪,不受薄膜和晶圆材料的限制。该系统为大容量生产设计有一个吞吐量和维护优化布局的半导体磁带处理机器人,可容纳所有标准尺寸的晶圆。此外,一个集群配置有两个处理室和两个磁带负载锁是可用的。
特点和益处:
产量显著提高
薄膜厚度均匀性要调整到0.1纳米原子级
无边缘与静电卡盘排斥
零基蚀刻功能的亚纳米去除
无限制地加工薄膜和晶圆材料
低生产成本的产量和维护优化设计
由于晶圆冷却良好,用光刻胶面罩加工晶圆
应用程序:
结果IBT
结果(左前、右后)铝氧化物在200mm晶圆上的离子束切割。标准偏差:前:9.4纳米,柱:0.4纳米;改进系数:23.5纳米;平均厚度:前:383.3纳米,柱:360纳米;目标:360纳米
体声波滤波器或表面声波滤波器的频率削减
绝缘体(SOI)、石英、钛酸锂(LT)或氮化锂晶圆片上硅的厚度削减
薄膜表面厚度误差或一步高度校正(TFH)制造
MEMS结构的尺寸校正
X光镜格式错误校正
申请表:
保真滤波器 作为移动通信中的高频滤波器
锯片机 在移动通讯中抑制频率
POI晶圆的厚度调整 用于射频滤波器(锯片)
纸张厚度修正读写头 就硬盘而言
X射线镜表面误差校正
原则:
在低污染的垂直设置中,专注于宽离子束扫描晶圆表面
通过调整停留时间控制局部材料的清除
技术:
离子束修剪 是通过调整停留时间来控制通过晶圆和局部材料去除的聚焦宽离子束扫描的地方。
反应离子束修剪 将活性气体引入离子束源,用于表面的活性结构。
离子束计算 是一个抛光错误修正扫描离子束和停留时间控制。
底板尺寸
(
最大
)
200
毫米口径。
,
所有标准晶圆尺寸均可
基座
水冷、氦背面冷却接触、无边缘排除的静电夹紧
AXX
表现
麦克斯。最大速度
0.5
米
/
秒。加速度
15
米
/
离子束源
37mm
循环射频源
(rf37i),8
。
..15
毫米
(FWM)
或
80 mm circular RF source (RF80-i) with 12 ... 20 mm (FWHM)
中和器
热灯丝中和器或射频等离子桥中和器
产量
15
个晶圆
/
小时
(150mm
晶圆上
50
纳米硅
)
碱压
< 1 x 10 -6
马巴
系统尺寸
(WxDxH)
带磁带处理的单室
(
没有电架和泵
)
反对者
菲
盖朗斯
单室
,
带单衬底负载锁定或磁带处理
,
集群系统
,
包括
2
个工艺室和磁带处理
软件接口
SECS II / GEM, OPC
典型清除率
高级官员
2 : 6 x 10 -3
毫米
3 /s (RF37-i), 11 x 10 -3
毫米
3 /s (RF80-i)
剪裁后的电影变化
半纳米
RMS(
取决于输入质量
)
2、Scia Trim300
在300毫米以下的晶圆片上精确的均匀薄膜表面校正
离子束修剪
离子束图
咨询电话:13522079385
离子束修剪精确校正表面
… 右边300 是一个高产量的生产系统 离子束修剪 不受材料限制的300毫米晶圆。该衬底的精确局部表面校正是由具有足够小焦点的聚焦宽离子束进行的。控制局部材料去除导致不均匀性蚀刻到一个令人印象深刻的均匀膜,从而显著增加可用组件的产出。
特点和益处:
产量显著提高
薄膜厚度均匀性要调整到0.1纳米原子级
无边缘与静电卡盘排斥
零基蚀刻功能的亚纳米去除
无限制地加工薄膜和晶圆材料
低生产成本的产量和维护优化设计
由于晶圆冷却良好,用光刻胶面罩加工晶圆
应用程序:
结果IBT
离子束修剪结果(左、右) 2 在300毫米的晶圆片上。
标准差:前:1.3纳米,柱:0.3纳米;改进系数:4.3;平均厚度:前:107.7纳米,柱:955.1纳米;去除:55.6纳米
体声波滤波器或表面声波滤波器的频率削减
绝缘体(SOI)上硅的厚度调整,
MEMS结构的尺寸校正
申请表:
保真滤波器 作为移动通信中的高频滤波器
锯片机 在移动通讯中抑制频率
原则:
在低污染的垂直设置中,专注于宽离子束扫描晶圆表面
通过调整停留时间控制局部材料的清除
技术:
离子束修剪 是通过调整停留时间来控制通过晶圆和局部材料去除的聚焦宽离子束扫描的地方。
反应离子束修剪 将活性气体引入离子束源,用于表面的活性结构。
离子束计算 是一个抛光错误修正扫描离子束和停留时间控制。
底板尺寸
(
最大
)
300
毫米口径。
,
所有标准晶圆尺寸均可
基座
水冷、氦背面冷却接触、无边缘排除的静电夹紧
AXX
表现
麦克斯。最大速度
0.25
米
/
秒。加速度
15
米
/
离子束源
37mm
循环射频源
(rf37i),8
。
..15
毫米
(FWM)
或
80 mm circular RF source (RF80-i) with 12 ... 20 mm (FWHM)
中和器
热丝中和器
(N-Fil)
产量
6
晶圆
/
小时
(300mm
晶圆上
50
纳米硅
)
碱压
< 1 x 10 -6
马巴
系统尺寸
(WxDxH)
3.20
米
x2.90
米
x2.20
米
,
单腔
,
在
270
度安排下
(
没有电架和泵
)
配置
带磁带处理或集群系统的单室
,
有两个加工室和磁带处理
软件接口
SECS II / GEM, OPC
典型清除率
高级官员
2 : 6 x 10 -3
毫米
3 /s (RF37-i), 17 x 10 -3
毫米
3 /s (RF80-i)
剪裁后的电影变化
半纳米
RMS(
取决于输入质量
)
3、Scia Trim1500
高精度光学元件抛光误差修正高达1500mm。
离子束图
镜头和镜子的抛光错误纠正:
… 完成1500 用于高精度光学元件的表面形状误差校正。该系统适用于高产量生产,由于快速抽抽时间和离子束源的高去除率,24/7运行。
特点和益处:
光学元件可重复质量的长期稳定过程
在大面积上非常精确
高吞吐量的高清除率
滑动门可方便地装载大型基板
设计用于高产量生产,短泵降落时间
应用程序:
结果(左前、右后)模拟了1,500mm以上镜离子束图形。标准偏差:前:256纳米,柱:1.9纳米;范围:前:1550纳米,柱:85纳米
透镜和镜子的最终表面形式错误校正
望远镜镜(零杜尔、西东、图腾)
常规光学(石英和其他玻璃)
X射线光学离子束图形
申请书:
格式错误更正 用于X光镜
原则:
针对低污染背景下垂直设置的宽离子束扫描
去除不同数量物质的时间控制
技术:
离子束计算 是一个抛光错误修正扫描离子束和停留时间控制。
底板尺寸
(
最大
)
1500
毫米口径。
,400
公斤
轴性能
麦克斯。最大速度为每秒
0.15%
米。加速度
15
米
/
离子束源
37mm
循环射频源
(rf37i),8
。
..15
毫米
(FWM)
或
120 mm circular RF source (RF120-i) with 16 ... 36 mm (FWHM),
可选的第二离子束源
中和器
射频等离子体桥中和剂
碱压
< 1 x 10 -6
马巴
系统尺寸
(WxDxH)
3.60
米
x7.70
米
x3.40
米
(
没有电动机架和水泵
)
配置
单室滑动门
,
手动装载运输车
,3
或
4
轴控制系统
离子束运动
软件接口
SECS II / GEM, OPC
典型清除率
高级官员
2 : 14 mm 3 /h (RF37-i), 96 mm 3 /h (RF120-i)
厚度变化
在
ibf
之后
半纳米
RMS(
取决于输入质量
)